Разработка учебно-научной
программы для исследования характеристик МДП-структуры
А.Ю. Красюков,
доц., к.т.н., доц., е-mail: a_kras@org.miet.ru
МИЭТ, г. Москва, Зеленоград
В результате работы была создана одномерная численная модель для расчета
электрических характеристик МДП-структур, позволяющая наглядно и адекватно отобразить
процессы внутри прибора. Модель построена на основе численного решения
уравнения Пуассона в пятислойной структуре, состоящей из диэлектрических и полупроводниковых
материалов. Рассмотрены примеры, наглядно иллюстрирующие возможности модели по
расчету и иллюстрации параметров МДП-структуры. Результаты работы создают
основу для дальнейшего совершенствования возможностей модели по описанию
современных МДП-структур.
One
dimensional numerical model for MIS-structures characterization is presented.
Model is based on solving the Poisson equation in a five-layer structure from
insulators and semiconductors. Model capabilities were considered in several examples.
При разработке и оптимизации конструкции и технологии
изготовления элементов интегральных схем, как правило, используются средства приборно-технологического
моделирования (TCAD). TCAD является универсальной средой с широкими возможностями
по моделированию различных полупроводниковых приборов сложной формы [1]-[2].
Однако такая универсальность несколько затрудняет
изучение системы TCAD, а также неудобна для
иллюстрации физики работы простых полупроводниковых приборов, например
процессов, происходящих в МДП - структурах с произвольным распределением
примеси в подложке. На этапе изучения физики полупроводниковых приборов
требуется простая программа, позволяющая рассчитывать и сразу отображать
основные распределения для МДП - структуры в одномерном приближении.
Разрабатываемая программа
является специализированным инструментом для расчета характеристик и
отображения процессов в МДП - структурах в одномерном приближении.
Программа имеет графический интерфейс, позволяющий
создавать одномерную модель МДП - структуры, задавать произвольное
распределение примеси в подложке. Одномерная модель состоит из пяти областей,
что позволяет исследовать следующие МДП-структуры:
- МДП-структура с n- или p-подложкой
и металлическим затвором.
- МДП-структура с n- или p-подложкой
и n+- или p+-Si*-затвором, позволяющая оценить
эффект обеднения Si*.
- МДП-структура с
металлическим или Si*-затвором и многослойным подзатворным диэлектриком
(до трех слоев) c возможностью задания различной диэлектрической
проницаемости и заряда на границах раздела материалов.
Программа позволяет рассчитать пороговое напряжение
и СV-характеристики МДП-структуры.
Рассмотрим несколько примеров использования
численной модели для исследования работы МДП-структуры.
Вид окна программы для создания 1D-модели
МДП-структуры с n+-Si*-затвором и постоянным
распределением примеси в подложке показан на рис.1.1.

рис.1.1 Создание 1D-модели
МДП-структуры с n+-Si*-затвором. Распределение N(x)
Результаты моделирования показаны на рис.1.2-1.3.
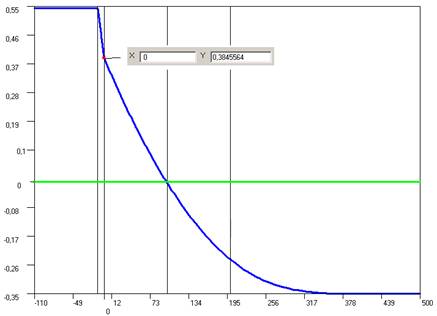
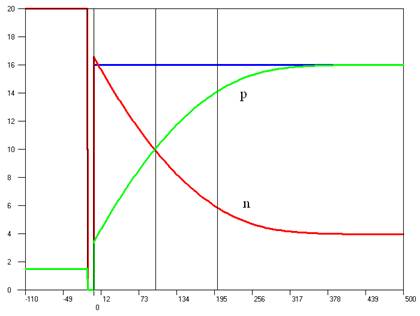
рис.1.2 Распределение φ(x) (слева), n,p,N(x)
(справа) полученные при Uзп=0 В
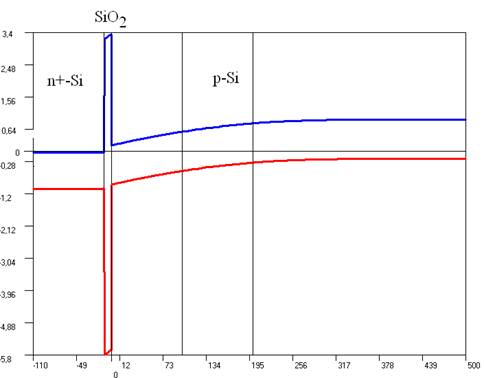
рис.1.3 Распределение Eс, Ei, Ev(x), полученное при Uзп=0 В
Результаты расчета при Uзп=0 В позволяют сделать
следующие выводы:
- Потенциал подложки φп=-0.35
В (Fip)
- Потенциал затвора (при X=-10 нм) φз=0.55
В
- Напряжение плоских зон Uпз=-(φз -
φп) = -0.88 В
- Поверхностный потенциал φs=φ(X=0)-φ(X=500
нм) = 0.38-(-0.35)=0.88 В
- Так как (|2·φп|=0.7|)
<(|φs|=0.88) то при Uзп=0В рассматриваемая
МДП-структура находится в режиме сильной инверсии
- Так как рассматриваемая структура при Uзп=0В находится в режиме
сильной инверсии, то ее пороговое напряжение Uпорог ≤ 0.
Так как структура находится в режиме сильной
инверсии уже при Uзп=0 В то следует провести исследование работы
МДП-структуры в интервале Uзп=[-1; +1] В. Результаты моделирования показаны на рис.
1.4-1.5.

рис.1.4 Зависимость
поверхностного потенциала МДП - структуры c n+-Si*-затвором
от напряжения Uзп
Из рис.1.4 следует, что напряжение на границе
режимов слабой и сильной инверсии (пороговое напряжение) Uпорог
= -0.05 B, а
напряжение плоских зон Uзп(Fis=0)≈-0.9В.
Рассмотрим случай, когда МДП-структура имеет p+-Si*-
затвор. Результаты расчета зависимости плотности инверсного заряда в канале для
n+- и p+-Si*-затворов показаны на
рис.1.5.
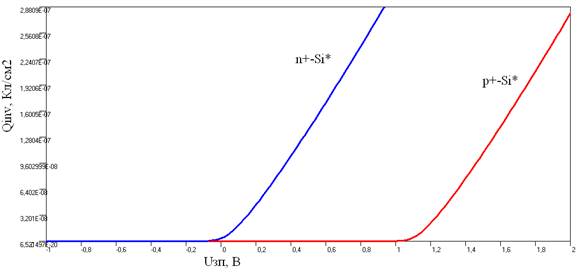
рис.1.6 Зависимости плотности инверсного заряда в
подложке p-типа от напряжения Uзп для МДП-структур с n+-Si*- и p+Si*-затворами
Из рис.1.6 наглядно видно, что замена типа
проводимости Si*-затвора с n+- на p+-
приводит к
увеличению порогового
напряжения от 0 до 1.1 В.
Рассмотрим пример расчета характеристик
МДП-структуры с неравномерным распределением примеси в подложке. Распределения
примеси, и результаты расчетов приведены на рис.1.7.
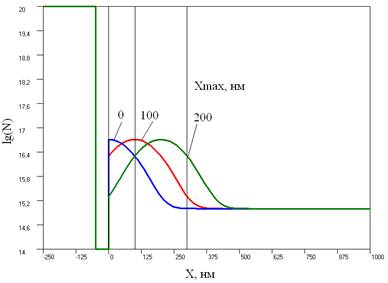
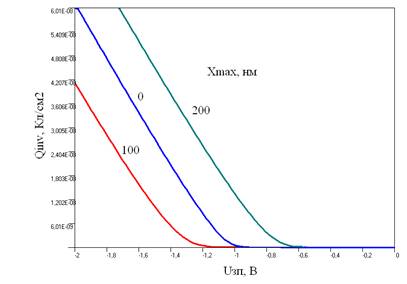
рис.1.7 Неравномерные распределения примеси в
МДП-структуре (слева) и зависимости инверсного заряда от напряжения
на МДП-структуре (справа)
Из рис. 1.7 можно оценить зависимость порогового
напряжения от параметра Xmax, как показано на рис.1.8.
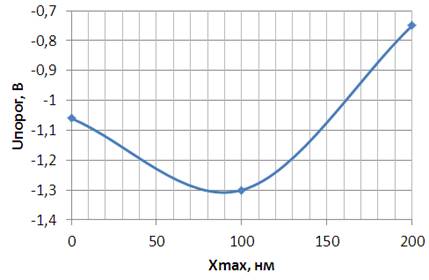
рис.1.8 Зависимость Uпорог(Xmax)
Рассмотрим влияние эффекта обеднения носителями n+-Si*-затвора
на характеристики МДП-структуры. На рис.1.9 показано распределение концентрации
электронов, дырок и примеси вблизи канала, рассчитанное при Uзп=1В.

рис.1.9 Распределения концентраций,
полученные при Uзп=1 В
Из рисунка 1.4 видно, что при работе МДП-структуры
в режиме сильной инверсии происходит обеднение слоя n+-Si* вблизи границы раздела Si*-SiO2 на 2 нм, что сопоставимо с
толщиной подзатворного оксида (3 нм)
Результаты расчета параметров МДП-структуры с
учетом и без учета эффекта обеднения Si*-затвора показаны на рис.
1.10, из которого видно, что обеднение n+-Si*-затвора электронами
приводит к увеличению порогового напряжения МДП-структуры и уменьшению тока стока
МДП-транзистора по сравнению со случаем отсутствия обеднения.
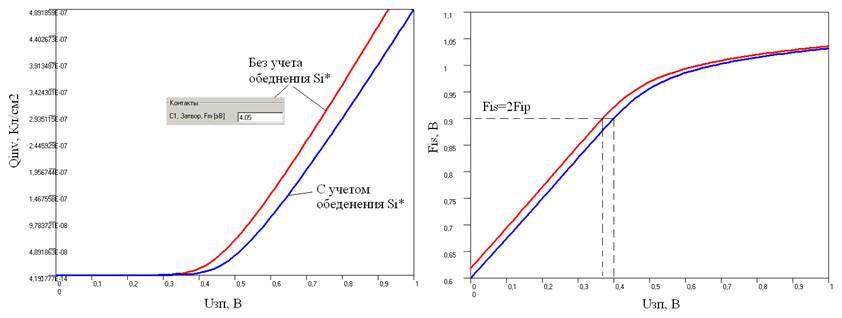
рис.1.10 Зависимость
плотности инверсного заряда в подложке p-типа и поверхностного
потенциала от напряжения Uзп
Рассмотрим пример расчета характеристик
МДП-структуры с равномерным распределением примеси в подложке, n+-Si*-затвором
и составным диэлектриком Si3N4/SiO2=2/1 нм. Распределение
примеси, и результаты расчетов приведены на рис.1.11-1.12.

рис. 1.11 – Распределение
примеси и узлы сетки для рассматриваемой структуры
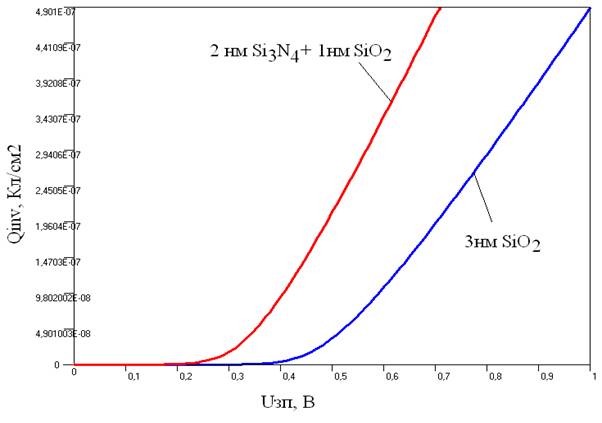
рис. 1.12 Зависимость
плотности инверсного заряда в подложке p-типа от напряжения Uзп с учетом различного состава подзатворного диэлектрика
Из рисунка 1.12 видно, что при одинаковой толщине
подзатворного диэлектрика (3 нм), структура с диэлектриком Si3N4/SiO2 (high-k) имеет меньшее пороговое
напряжение и больший ток стока, чем структура SiO2 –диэлектриком.
В дальнейшем планируется расширение возможностей
программы, а именно:
·
Моделирование работы МДП-структуры на основе КНИ-подложки.
·
Учёт влияния эффекта квантования носителей в канале на электрические
характеристики структуры.
·
Расчёт тока затвора МДП-структуры.
Литература
1. http://www.synopsys.com/tools/tcad/Pages/default.aspx